Los procesadores en los últimos años han evolucionado bastante hacía nuevos diseños más flexibles, que facilitan su desarrollo. Intel ha optado por crear un sistema de núcleos heterogéneo que es similar al diseño big.LITTLE de ARM. Estos se comunican mediante un sustrato de vidrio del cual Intel reemplazará los materiales orgánicos y que ofrecerá interconexiones más altas.
Vemos como la industria se mueve hacia la creación de complejos sistemas denominados chiplets. Esto no es más que agregar varios conjuntos de silicio sobre una superficie e interconectarlos. Algo que parece «sencillo», realmente esconde una enorme complejidad, ya que se requieren líneas de comunicación grandes.
Ante un aumento de este tipo de diseños, los fabricantes trabajan en soluciones de comunicación entre los DIE. Se requieren de nuevas tecnologías que permiten reducir al mínimo las latencias y, por tanto, que no exista afectación al rendimiento.
El vidrio, nuevo sustrato para procesadores
Intel lleva años desarrollando soluciones que permitan una interconexión mucho más eficiente. La última solución que han desarrollado pasa por «sustratos de vidrio» para reemplazar el embalaje orgánico usado en los chips actuales.
Según la compañía, estos sustratos de vidrio son el camino a seguir en el futuro. La tecnología de empaquetado podría permitir innovaciones a gran escala dentro de las industrias, sobre todo en HPC e IA. Era necesaria una solución para estas industrias que se mueven claramente hacía los chiplet.
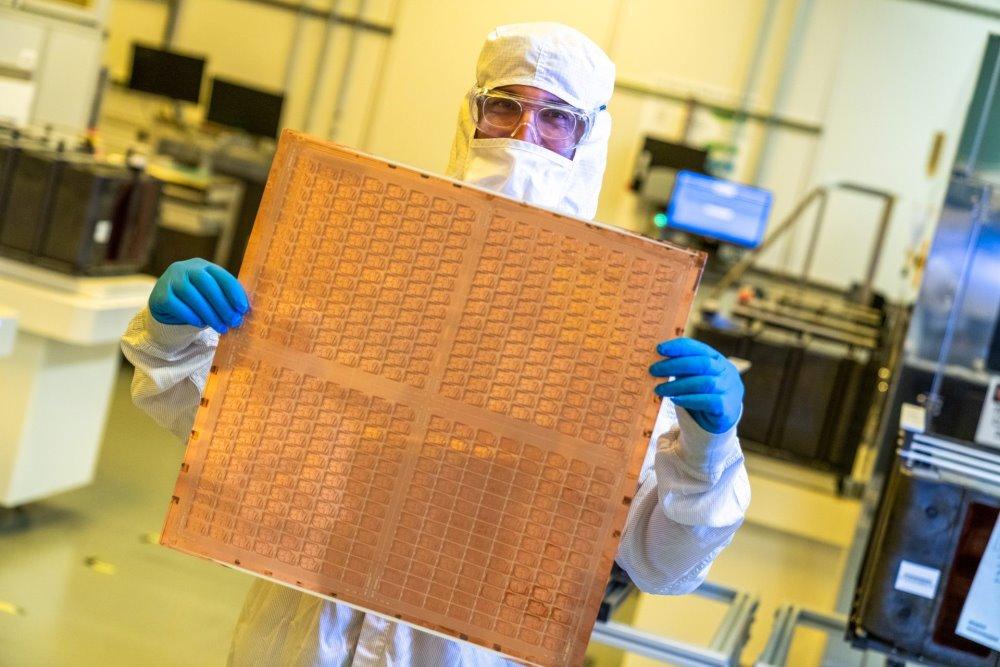
Después de una década de investigación, Intel ha logrado sustratos de vidrio líderes en la industria para envases avanzados. Esperamos ofrecer estas tecnologías de vanguardia que beneficiarán a nuestros actores clave y clientes de fundición en las próximas décadas.
Babak Sabi, vicepresidente senior de Intel
La calidad del sustrato se mide por la cantidad de chiplets que se pueden agregar en un único paquete. Intel destaca que sus sustratos de videos pueden usarse para «complejos chiplets más grandes». Permite la reducción de la capacidad de tamaño de un solo paquete, ofreciendo un aumento de rendimiento y siendo más eficiente.
Este nuevo sustrato de vidrio, además, presenta una mejor tolerancia a la temperatura y un diseño más plano. Se consigue con esto una mayor conectividad entre las capas. Intel destaca que los sustratos de video permiten aumentar la densidad de interconexión en hasta 10 veces. Gracias a este nuevo diseño se consigue una entrega de energía perfecta.
Gracias a eliminar los materiales orgánicos se consigue que los chips puedan ser mucho más delgados. Este nuevo diseño también aumenta la interconexión en hasta 10 veces, permitiendo diseños de chiplets más avanzados hasta ahora imposibles.

¿Quiénes lo podrán utilizar?
Intel de momento no ha dicho cuando se lanzará este empaquetado basado en sustrato de vidrio. Lo cierto es que esta solución acerca a la compañía al objetivo de los mil millones de transistores para 2023.
Ayer mismo se comentaba que NVIDIA estaba trabajando en chiplets para sus próximas GPU destinadas a Data Centers e IA. Uno de los aspectos que se destacaba es la necesidad de un sustrato que permitiera crear estas soluciones.
Recientemente, Intel anuncio su intención de abrirse como fundición para terceras empresas. Así que uno no puede dejar de sumar dos más dos. CoWoS de TSMC, que es la única alternativa interesante que existe, está muy por detrás de la tecnología de sustrato de Intel actual y también, de esta nueva.
Pero, ¿Intel tiene la capacidad de satisfacer la brutal demanda de NVIDIA?