Siempre se buscan nuevos procesos y técnicas que permitan mejorar el rendimiento y aumentar la eficiencia. Nos ha sorprendido la idea de Samsung, que estaría ultimando un tipo de empaquetado 3D para las memorias de alto ancho de banda (HBM). Concretamente, la idea de Samsung es instalar las memorias HBM sobre el propio procesador.
Las memorias HBM (High Bandwidth Memory) se caracterizan por instalarse junto al procesador o la GPU. Están muy cerca para, precisamente, poder explotar su principal característica, que es un elevado ancho de banda. Sobre todo son muy interesante para la inteligencia artificial, donde se trabajan con grandes flujos de datos.
Presentan, por otro lado, diferentes problemas. El más notable es que las memorias HBM son mucho más caras de fabricar que las GDDR usadas en gráficas gaming. Otro de los problemas es el ensamblado, ya que evitar que existan diferencias de altura entre los elementos, es complicado.
Samsung propone poner las memorias HBM sobre la CPU
Como comentábamos, las HBM se colocan alrededor de la CPU o la GPU, situándose muy cerca para aprovechar todo el ancho de banda. Samsung habría desarrollado una nueva tecnología que permite instalarla directamente sobre el chip.
Esta nueva tecnología de empaquetado 3D recibe el nombre de SAINT (Samsung Advanced Interconnect Technology) y tiene tres variantes, las cuales son:
- SAINT-S está diseñada para memorias SRAM
- SAINT-L diseñada para lógica
- SAINT-D se ha creado para apilar DRAM
La compañía habría destacado que llevan trabajando en la variante SAINT-D desde 2022, cuando lo anunciaron oficialmente. Parece que actualmente esta tecnología está lista y se empezará a usar este año.
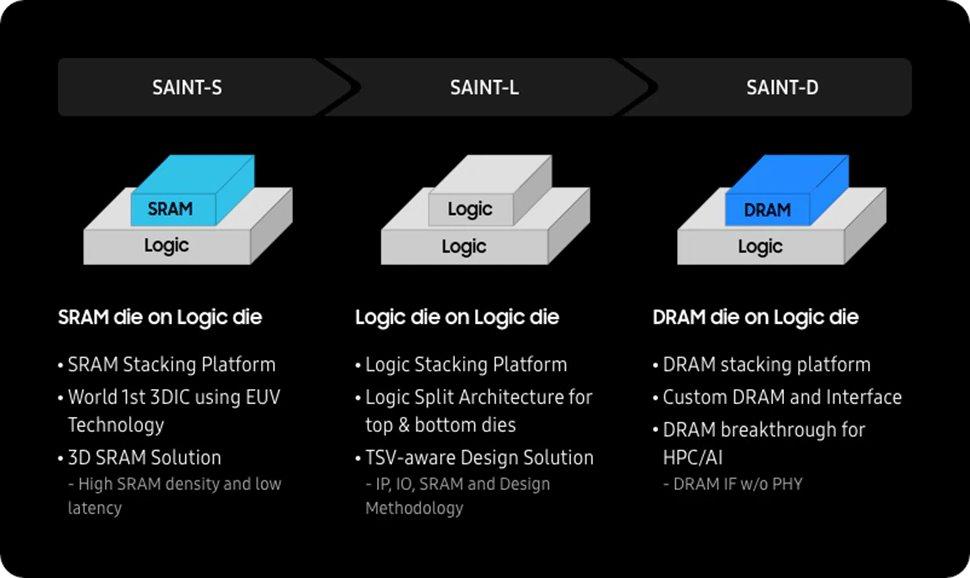
Samsung indica que el método SAINT-D está enfocado a apilar chips HBM sobre el procesador. Este mecanismo difiere de la tecnología 2.5D donde se conectan los chips HBM y la GPU de manera horizontal mediante un interposer. Usar un apilamiento vertical elimina la necesidad del interposer comunicando la memoria HBM directamente con el chip mediante un proceso sofisticado.
Ofrece esta nueva tecnología, una transferencia más rápida de los datos, señales más limpias, menor consumo de energía y latencias más bajas. No todo es positivo, ya que este empaquetado tiene un coste relativamente alto. Este diseño se postula como excelente para los aceleradores de inteligencia artificial y campos donde se deba procesar una gran cantidad de datos.
La idea de Samsung es ofrece este empaquetado HBM 3D sea un servicio llave en mano. Su división de memorias sería la encargada de producir las HBM y la división de fundición de la fabricación de los chips y el ensamblaje para empresas que no tengan división de fundición.

Desconocemos, de momento, como plantea Samsung ofrecer el diseño SAINT-D este mismo año. Instalar una memoria HBM sobre el chip requiere que esté diseñado específicamente para soportar esta construcción. Actualmente, no tenemos constancia de ninguna empresa que tenga un chip capaz de soportar la memoria encima.
Nos surge la duda de la temperatura, ya que el calor generado por el procesador pasa a las memorias y luego se disipará. Desconocemos se comporta en este sentido, pero parece que podría hacer que la CPU o GPU trabaje a una temperatura más elevada. Imaginamos que Samsung dará más información próximamente.

