La época de la inmersión y grabado de obleas ha terminado oficialmente, y aunque Intel sigue algo rezagada en cuanto a las tecnologías empleadas en EUV, su hoja de ruta las incluye muy claramente. Samsung y TSMC están trabajando ya con patrones EUV, pero la industria está realmente preocupada, ya que se presentan retos para llegar a los 3 nm y sobre todo a nodos inferiores. ¿Cómo crearán los nuevos procesos litográficos más perfectos para CPU y GPU? Con EUV High-NA.
¿Es posible y factible a día de hoy reducir el tamaño de los transistores por debajo de los mencionados 3 nm? La industria abre varios frentes con ASML a la cabeza, mientras que otros muchos se están preguntando cómo vamos a llegar a crear máscaras para longitudes de onda tan pequeñas. ¿Cuáles son los problemas?
Nuevos escáneres, nuevos procesos de resistencias y máscaras con EUV High-NA

Tres son los pilares principales del grabado de obleas en la actualidad y en los años venideros: los escáneres que proporciona la mencionada ASML, las resistencias para las máscaras y las propias máscaras.
¿Por qué los escáneres son un problema? Principalmente porque reducir la longitud de onda de 193 nm es realmente complicado, ya que se necesita una lente de apertura numérica (NA) de 0,33 con resoluciones de 13 nm y con un rendimiento por oblea lo más alto posible.
EUV es una tecnología que funciona con pulsos de láser que golpean pequeñas gotas de estaño a una velocidad altísima, lo cual genera fotones y estos rebotan en varios espejos dentro del escáner para terminar reflejados en la máscara y luego en la oblea, dando forma a los transistores.
El problema es que los fotones no terminen en la oblea, sino que se queden en la máscara, o que directamente se pierdan por los bordes. La solución sería usar películas que protejan la oblea, pero la tecnología no está lista así que empujados por la competencia todos se han tirado a grabar a 193 nm sin ellas, lo que es factible a 7 nm y los futuros 5 nm.
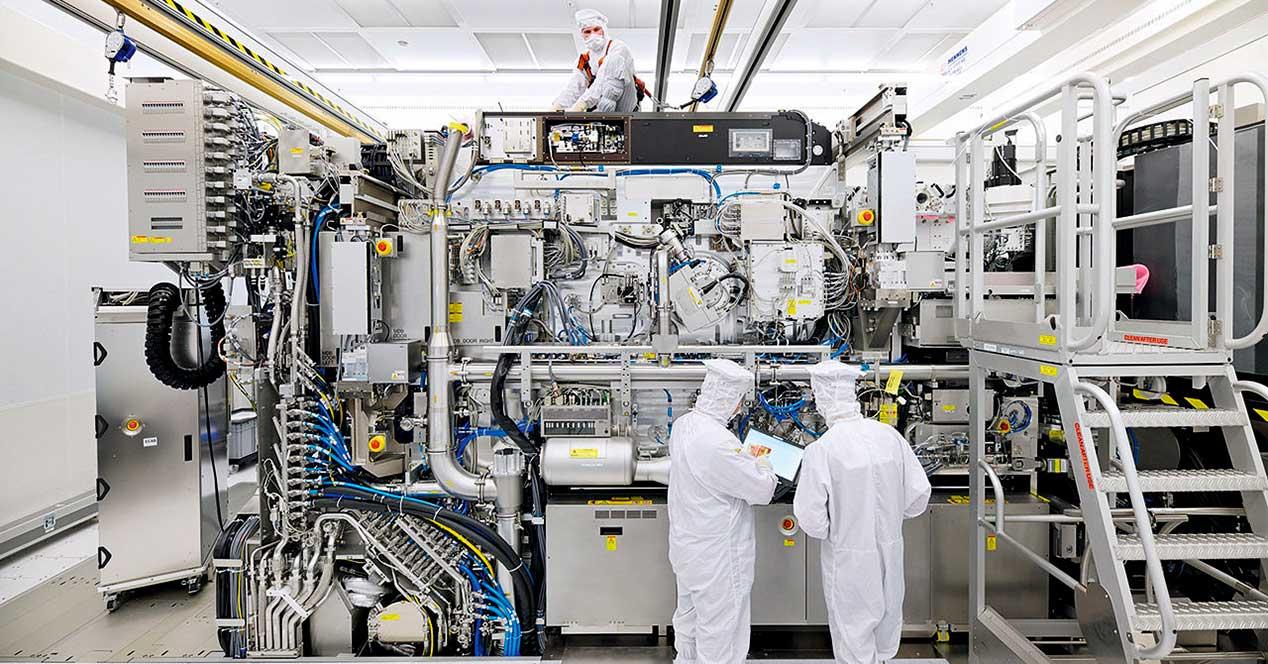
Y esto es así porque se usa un patrón simple y no múltiple, ya que puede tener un pitch gate de 32 nm o 30 nm, pero reducirlo implica cambiar de escáneres para llegar a 3 nm o menos. La respuesta volverá a darla ASML con un escáner de 0,55 NA capaz de grabar a resoluciones de 8 nm, un avance gigantesco.
Estos escáneres serán llamados coloquialmente como High-NA y permitirán volver al patrón único de diseño, reduciendo los costes y progresivamente incrementando las obleas por hora. El problema es que para que funcionen hacen falta dos máscaras y no una, las cuales tienen que coserse juntas para una oblea debido a su complejidad.
Esto disparará el coste, el cual ya es prohibitivo a día de hoy, ya que, por ejemplo, un escáner actual EUV está sobre los 153 millones de dólares, mientras que los High-NA estarán sobre los 318 millones. ¿Eso significa que los procesadores aumentarán de precio, así como las GPU? Es bastante probable si no encuentran solución.
Las resistencias para las obleas también están en un callejón sin salida

Antes de crear un patrón para una oblea esta se inserta en un sistema llamado revestidor, tras lo cual se vierten los materiales fotorresistentes para la oblea, la cual gira para dejar una capa uniforme que la proteja.
Tras eso llegará el grabado en el escáner de litografía, así que es un proceso previo muy importante. Actualmente hay dos sistemas para hacer esto en EUV: amplificada químicamente o CAR y las basadas en el llamado óxido metálico.
El problema de las CAR es que sufren desenfoque de la lente del escáner, lo que no permite unas resoluciones tan grandes en estos, por no hablar de los que vienen con NA. Las resistencias de óxido metálico son más aptas ante estos fallos, pero en cambio son menos estables, por lo tanto no hay un sistema que sea 100% fiable y sobre todo rentable.
Sin embargo, se está trabajando en un sistema llamado fotorresistencia seca, un sistema para quitar humedad y mejorar la resolución y estabilidad mediante una capa protectora en una cámara de procesamiento seca antes de la exposición a los fotones. Esta será válida para EUV y EUV NA, pero tardará en llegar algunos años.
Las fotomáscaras tampoco se libran y tienen que mejorar
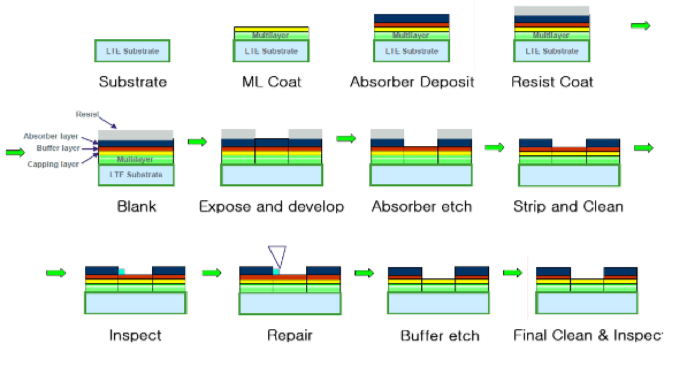
Una máscara EUV actual consta de entre 40 y 50 capas delgadas de silicio y molibdeno sobre un sustrato, dando un grosor total que suele estar entre los 250 nm y 350 nm. Cada máscara tiene un componente llamado «absorbente» el cual evita que haya rebotes de la luz en la oblea y ayuda a un grabado más perfecto.
El problema es que en un sistema EUV la luz llega a la máscara en un ángulo de 6º, lo que potencia el hecho de que se refleje y el absorbente no pueda hacer todo el trabajo, provocando posibles cambios de ubicación en los patrones, con el consecuente deterioro de la oblea.
¿Cómo solucionar esto? Con absorbentes más finos. Los actuales son de 60 nm y los mejores y más caros de 50 nm, pero no son capaces de arreglar esto y menos a longitudes de onda más pequeñas y altas. Por ello los investigadores están creando dos nuevos tipos de máscaras para los futuros procesos litográficos en EUV: las llamadas High-K y las Phase-Shift.
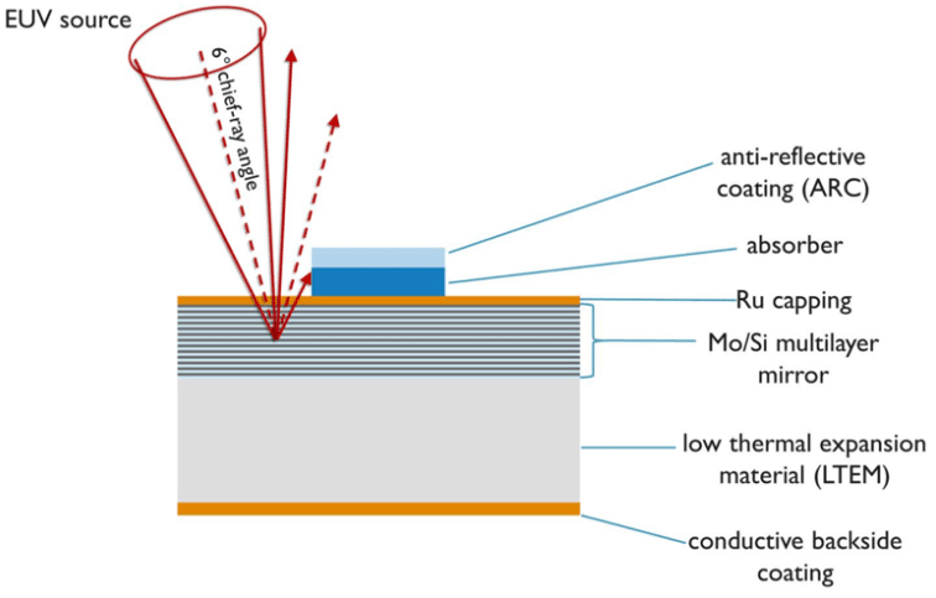
Estas últimas son las más sencillas, porque solo requiere cambiar el material absorbente por uno con propiedades Low-N, dejando de lado al tantalio. Lo que se busca es bloquear la luz y evitar que se refleje, logrando zonas oscuras y por lo tanto mejorando la precisión de las imágenes con más contraste de base.
De las High-K se sabe muy poco, pero parece que podrán ser reparadas con un láser, bajando los costes de fabricación finales, ya que las máscaras son extremadamente caras y se necesita una para cada patrón.
En resumen, los 7 nm y 5 nm están garantizados, pero bajar a 3 nm no va a ser tan fácil pese a que Tanto Samsung como TSMC como Intel aseguran tenerlos listos para 2025 en el peor de los casos.